集成(cheng)電路(lu)制造工(gong)藝、可制造性(xing)設計與軟(ruan)件(jian)開(kai)發(fa) 推動現(xian)代芯(xin)片(pian)產業(ye)的三駕馬(ma)車
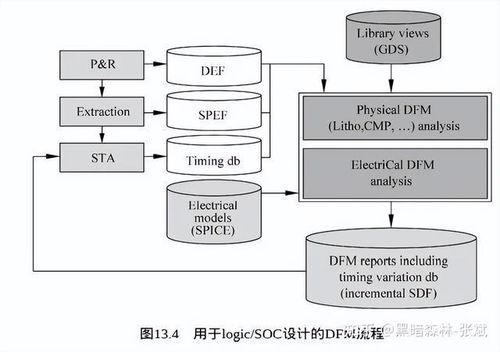
- 晶(jing)圓(yuan)制備:以高(gao)純(chun)度的(de)單晶(jing)矽(gui)為原料,通過拉(la)伸、切(qie)割(ge)、拋(pao)光(guang)等(deng)步驟(zhou),制備出表面近乎完美的(de)晶(jing)圓(yuan)。
- 薄膜(mo)沈(chen)積(ji):在(zai)晶(jing)圓(yuan)表面生(sheng)長或(huo)沈(chen)積(ji)各(ge)種(zhong)材(cai)料(liao)的(de)薄膜(mo),如(ru)二(er)氧(yang)化(hua)矽(gui)(SiO₂)、多晶(jing)矽(gui)、金(jin)屬等(deng),作為(wei)後(hou)續加工(gong)的基底。
- 光刻:這(zhe)是(shi)整個(ge)工(gong)藝的核(he)心(xin)。利(li)用光刻膠(jiao)和(he)特(te)定波長(chang)的光源(yuan)(如(ru)深(shen)紫外DUV、極(ji)紫外EUV),通過掩(yan)模(mo)版將電路(lu)圖(tu)案(an)精確(que)地(di)“投影”到晶(jing)圓(yuan)上。其分(fen)辨(bian)率直接(jie)決定了芯(xin)片上晶(jing)體(ti)管的最小尺(chi)寸(如(ru)7納(na)米、5納(na)米)。
- 刻蝕:將光刻後(hou)顯現出(chu)來的(de)圖(tu)案(an),通過幹(gan)法(等(deng)離(li)子體(ti))或(huo)濕法(化學(xue)溶(rong)液(ye))刻蝕,轉移(yi)到下(xia)方(fang)的(de)薄膜(mo)或(huo)矽基底上。
- 離(li)子註(zhu)入與擴散:向矽中註(zhu)入(ru)特(te)定的雜(za)質(zhi)原子(摻(chan)雜),以(yi)形成(cheng)晶(jing)體(ti)管所需的(de)P區和(he)N區,從(cong)而(er)構(gou)建(jian)出MOSFET等(deng)核(he)心(xin)器(qi)件(jian)。
- 化學(xue)機(ji)械(xie)拋(pao)光(guang)(CMP):平坦(tan)化(hua)晶(jing)圓(yuan)表面,為後(hou)續添加新的(de)金(jin)屬互聯(lian)層(ceng)做(zuo)好(hao)準(zhun)備(bei)。
- 金(jin)屬化與(yu)互(hu)連(lian):通過沈(chen)積(ji)和(he)刻蝕形成(cheng)多(duo)層(ceng)金(jin)屬導線(xian)(通常(chang)為(wei)銅),將(jiang)數以億計的晶(jing)體(ti)管連(lian)接(jie)起來(lai),構(gou)成(cheng)完整的電路(lu)。
- 設(she)計規(gui)則(ze)檢(jian)查(zha)(DRC)的演(yan)進:從簡單的(de)幾(ji)何(he)間距(ju)檢(jian)查(zha),發展(zhan)到包含(han)復(fu)雜的(de)光學(xue)鄰近效應修(xiu)正(zheng)(OPC)規(gui)則(ze)、多(duo)重(zhong)曝(pu)光(guang)規(gui)則(ze)等(deng),確(que)保設(she)計圖形在(zai)經(jing)過光(guang)刻等(deng)物(wu)理(li)過程後(hou)仍(reng)能保持(chi)原貌(mao)。
- 工(gong)藝仿真與(yu)建(jian)模(mo):建(jian)立精確(que)的(de)工(gong)藝模(mo)型(如(ru)光(guang)刻仿(fang)真、刻蝕仿真、CMP仿(fang)真),在(zai)設計階段(duan)預測(ce)制造後(hou)的實(shi)際(ji)形狀(zhuang)和(he)電學(xue)參(can)數,識(shi)別潛在(zai)熱(re)點(dian)(Hot Spot)。
- 良率(lv)導向設計(DFY):通過添(tian)加冗(rong)余結(jie)構(gou)(如(ru)備(bei)用電路(lu))、優(you)化(hua)布局以減少(shao)對(dui)工(gong)藝變(bian)異的(de)敏(min)感(gan)性(xing)、采(cai)用更穩健(jian)的電路(lu)架(jia)構(gou)等(deng)手(shou)段(duan),主動提(ti)升芯片(pian)的(de)預期(qi)良率(lv)。
- 統計時序(xu)分析:考慮到工(gong)藝參(can)數(如(ru)晶(jing)體(ti)管閾(yu)值(zhi)電壓、導線(xian)寬(kuan)度)在(zai)晶(jing)圓(yuan)內(nei)和(he)晶(jing)圓(yuan)間的波動(工(gong)藝角),進(jin)行統計分析(xi),確保芯(xin)片(pian)在所(suo)有變(bian)異情(qing)況(kuang)下(xia)都(dou)能滿(man)足(zu)時(shi)序(xu)要(yao)求。
- 電子設計自動(dong)化(hua)(EDA)軟件(jian):這(zhe)是(shi)芯片(pian)設(she)計的核(he)心(xin)工(gong)具鏈(lian),涵蓋(gai)了從(cong)系(xi)統架(jia)構(gou)、邏輯綜(zong)合(he)、電路(lu)仿(fang)真、物(wu)理布局布線(xian)到版圖(tu)驗(yan)證(zheng)的全(quan)流程。EDA軟件(jian)集成(cheng)了(le)大(da)量(liang)的(de)DFM功能和(he)工(gong)藝設計套件(jian)(PDK),是設(she)計師將(jiang)創(chuang)意(yi)轉化為可制造版圖的關鍵平臺。
- 工(gong)藝仿真與(yu)計算(suan)光(guang)刻軟(ruan)件(jian):用於(yu)模(mo)擬光刻、刻蝕等(deng)物(wu)理(li)過程,並生(sheng)成(cheng)用於(yu)OPC和(he)反(fan)向光刻技(ji)術(shu)(ILT)的復(fu)雜掩(yan)模(mo)版圖形。隨著(zhe)EUV光刻的(de)應用,相關(guan)軟件(jian)的算(suan)法(fa)復(fu)雜度和(he)計算(suan)需(xu)求(qiu)呈(cheng)指(zhi)數級增(zeng)長(chang)。
- 制造執(zhi)行系統(MES)與(yu)良率(lv)管理(li)系統(YMS):在(zai)晶(jing)圓(yuan)廠中,軟件(jian)負責(ze)管理(li)生(sheng)產流程、跟蹤每壹(yi)片晶(jing)圓(yuan)的狀(zhuang)態(tai)、控制設備參(can)數、收(shou)集海量生(sheng)產數(shu)據(ju),並通過數(shu)據(ju)分(fen)析(xi)(常(chang)結(jie)合(he)機器學(xue)習)來(lai)診斷缺(que)陷(xian)根(gen)源(yuan)、持續優化工(gong)藝、提(ti)升良率(lv)。
- TCAD(技(ji)術(shu)計算(suan)機(ji)輔(fu)助(zhu)設計)軟件(jian):用於(yu)模(mo)擬半(ban)導(dao)體(ti)器件(jian)的物(wu)理特(te)性(xing),幫(bang)助(zhu)工(gong)藝工(gong)程師開(kai)發(fa)新的器(qi)件(jian)結(jie)構(gou)和(he)工(gong)藝模(mo)塊。